反应溅射
现代表面工程的发展越来越多地需要用到各种化合物薄膜,反应磁控溅射技术是沉积化合物薄膜的主要方式之一.沉积多元成分的化合物薄膜,可以使用化合物材料制作的靶材溅射沉积,也可以在溅射纯金属或合金靶材时,通入一定的反应气体,如氧气、氮气,反应沉积化合物薄膜,后者被称这反应溅射.通常纯金属靶和反应气体较容易获得很高的纯度,因而反应溅射被广泛的应用沉积化合物薄膜.反应溅射的优势有:
(1) 反应 磁控溅射所用的靶材料 ( 单元素靶或多元素靶 ) 和反应气体 ( 氧、氮、碳氢化合物等 ) 纯度很高,因而有利于制备高纯度的化合物薄膜.
(2) 通过调节反应磁控溅射中的工艺参数 , 可以制备化学配比或非化学配比的化合物薄膜,通过调节薄膜的组成来调控薄膜特性.
(3) 反应磁控溅射沉积过程中基板升温较小,而且制膜过程中通常也不要求对基板进行高温加热,因此对基板材料的限制较少.
(4) 反应磁控溅射适于制备大面积均匀薄膜,并能实现单机年产上百万平方米镀膜的工业化生产. 但是在沉积介电材料或绝缘材料化合物薄膜的反应磁控溅射时,容易出现迟滞现象,如图下所示.在反应磁控溅射的过程中,溅射沉积室中的反应气体流量较低时(A-B),大部分的反应气体被溅射金属所获,此时沉积速率较高,且几乎保持不变,此时沉积膜基本上属金属态,因此这种溅射状态称为金属模式.但是当反应气体的流量的值增加到临界值B 时,金属靶与反应气体作用,在靶表面生成化合物层.由于化合物的二次电子发射系数一般高于金属,溅射产额降低,此时反应气体的流量稍微增加(B-C),沉积室的压力就是突然上升,溅射速率会发生大幅度的下降,这种过程称为过渡模式.通常高速率反应溅射过程工作在过渡模式.此后反应气体流量再进一步增加,气体流量与沉积室压力呈线性比例,沉积速率的变化不大,沉积膜呈现为化合物膜,此时的溅射状态称为反应模式.在溅射处于反应模式时,逐渐减小反应气体流量(D-E),溅射速率不会由C 立刻回升到B,而呈现缓慢回升的状态,直到减小到某个数值E,才会出现突然上升到金属模式溅射状态时的数值,这是因为反应气体保持高的分压,直到靶材表面的化合物被溅射去除,金属重新曝露出来,反应气体的消耗增加,沉积室压力又降低,这样就形成了闭合的迟滞回线.类似于上述溅射速率与反应气体流量之间的迟滞回线的还有靶电压与反应气体流量之间的迟滞回线,两条迟滞回线的趋势完全相同.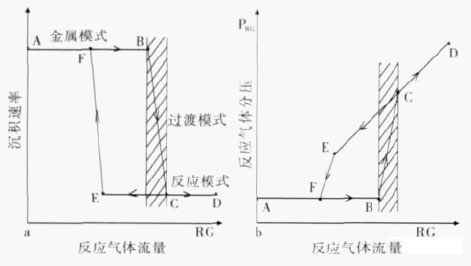
反应磁控溅射的迟滞现象示意图
反应溅射中的迟滞效应是不希望有的.迟滞现象使某些化学剂量比的化合物不能通过反应溅射获得,并且反应气体与靶材作用生成的化合物覆盖在靶材表面,积累大量的正电荷无法中和,在靶材表面建立越来越高的正电位,阴极位降区的电位随之降低,最终阴极位降区电位降减小到零,放电熄灭,溅射停止,这种现象称为"靶中毒".同时,在阴极附近的屏蔽阳极上也可能覆盖化合物层,导致阳极消失现象.当靶材表面化合物层电位足够高时,进而发生击穿,巨大的电流流过击穿点,形成弧光放电,导致局部靶面瞬间被加热到很高的温度,发生喷射,出现"打弧"现象.靶中毒和打弧导致了溅射沉积的不稳定,缩短了靶材的使用寿命,并且低能量的"液滴"沉积到薄膜表面,导致沉积薄膜结构缺陷和组分变异.为了获得稳定的控制方法,让溅射处在过渡模式下,还有通过等离子体发射光谱监控法和靶电压监控法来控制反应溅射过程.最为有效解决直流反应溅射靶中毒和打弧问题的方式是改变溅射电源,即采用射频,中频或脉冲电源.射频溅射在溅射靶与基体之形成高频(13.56 MHz)放电,等离子体中的正离子和电子交替轰击靶而产生溅射,解决了溅射绝缘靶材弧光放电的问题,但是相对于射频溅射速率较低,电源结构复杂,有辐射等问题.中频和脉冲电源容易获得,成为目前广泛应用的磁控溅射技术之一.常用的反应溅射应用有: